(2025) 半導體製程in-situ檢測設備技術。科儀新知,(242)。
本團隊針對半導體先進封裝技術中次微米級高深寬比微結構的檢測技術,已進行多項量測研究。由於高深寬比結構的幾何特性,對光學量測方法造成嚴重的照明遮蔽效應,如圖 1 所示,使得傳統光學檢測技術難以針對結構底部的幾何尺寸進行精確量測。此外,由於次微米級結構的幾何尺寸接近光學繞射極限,影像式量測方法難以進行關鍵尺寸量測。為此,本研究提出了一種基於模型的非直接量測方式,以利突破光學繞射極限的限制。此方法以物理電磁模擬模型為基礎,透過電磁模擬建立模擬量測訊號資料庫,並使用資料庫搜尋法匹配實驗訊號與模擬訊號,進而求解量測結構的關鍵尺寸,如圖 2 所示。
由於單一量測方法進行關鍵尺寸的反向求解時,極易受到關鍵尺寸間耦合效應的影響,降低量測準確度,因此本研究團隊提出了一種結合光譜反射術與波長掃描瞳面影像散射術的混合式量測策略。光譜反射術基於結構表面反射光與底部反射光間的雙光束干涉訊號進行關鍵尺寸量測,如圖 3 所示。此干涉光譜訊號為受到結構深度 d 與量測波長 𝜆 調製的餘弦訊號。由於結構底部反射光強訊號需乘上隨波長變化的消逝函數 𝜂(𝜆),且該函數會受到結構材料與幾何尺寸影響,因此需透過電磁模擬更精確地計算結構返回的雙反射光之光譜干涉訊號。由於結構底部反射光通過結構表面的次微米級開口時,因結構開口尺寸接近系統工作波長而產生繞射現象。在瞳面影像散射術中,本團隊將量測結構視為近似於週期性反射光柵的結構。透過匹配不同波長瞳面影像中的光強分佈資訊與繞射角度資訊與電磁模擬資料,即可對結構關鍵尺寸進行反向求解,如圖 4 所示。
本研究團隊透過對量測訊號的敏感度分析,將光譜反射術定為主要量測工具,瞳面影像散射術為輔助量測工具。透過將輔助量測工具的結果前饋給主要量測工具,可有效提升量測準確度,其流程如圖 5 所示。將混合式量測的結果與 FIB/SEM 量測結果相比,此混合量測策略可將各項關鍵尺寸的量測偏差控制在 3% 以內,且量測訊號與模擬訊號高度一致,如圖 6 所示。(機械系陳亮嘉教授提供)
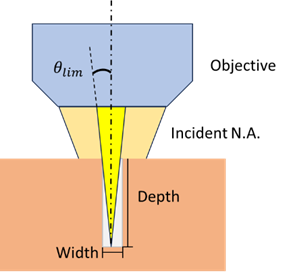
圖 1、高深寬比結構造成的遮蔽效應。

圖 2、基於模型的量測方式。
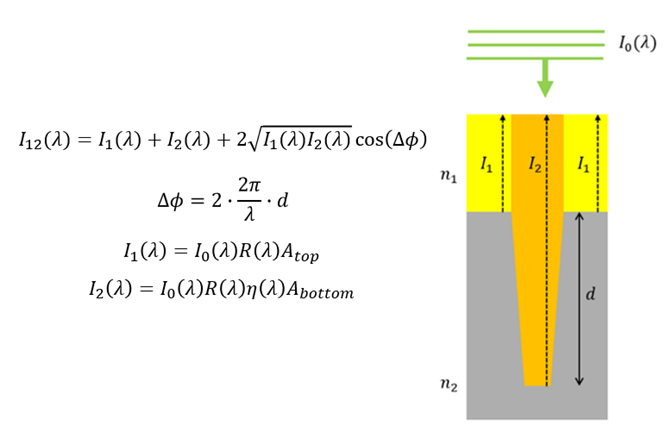
圖 3、微結構段差模型與其反射行為。
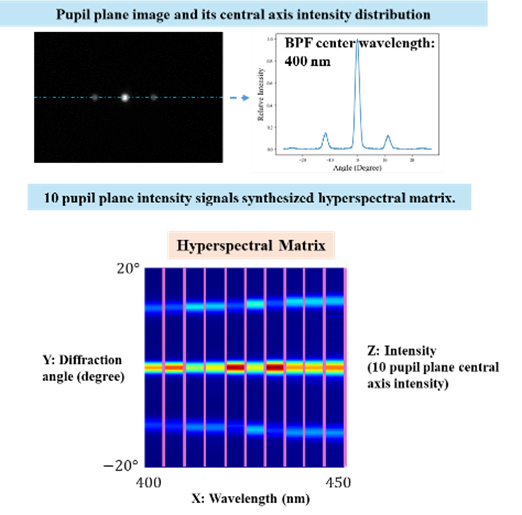
圖 4、波長掃描瞳面影像散射術。

圖 5、混合式量測策略。

圖 6、量測訊號與模擬訊號擬合結果。